我们知道,SiC MOSFET现阶段最“头疼”的问题就是栅氧可靠性引发的导通电阻和阈值电压等问题,最近,日本东北大学提出了一项新的外延生长技术,据说可以将栅氧界面的缺陷降低99.5%,沟道电阻可以降低85.71%,整体SiC MOSFET损耗可以降低30%。
9月28日,东北大学和CUSIC在“ICSCRM2023”会议上宣布,他们针对SiC MOSFET开发一种“同步横向外延生长法(SLE法)”,目的是通过在4C-SiC外延层上再生长3C-SiC层,来解决高温栅氧导致的可靠性问题。
为什么需要怎么做?传统4C-SiC栅氧层制备最大的问题是温度太高(约1300℃),这会导致SiO2/SiC界面出现碳残留,导致沟道迁移率低,以及可靠性和阈值电压等缺陷。
如果通过3C-SiC来制备栅氧层,工艺问题可以低于900℃,可以完美解决这个问题。根据“行家说三代半”之前的报道,3C-SiC MOSFET的n沟道迁移率范围为100-370 cm2/V·s。而4H-SiC MOSFET通常为20-40cm2/V·s,沟槽器件为6-90 cm2/V·s,京都大学的技术可以做到131 cm2/V·s,但也比3C-SiC MOSFET低3倍左右。

东北大学根据这思路制备了一种CHESS-MOSFET,即在4C-SiC叠加3C-SiC层,如下图:
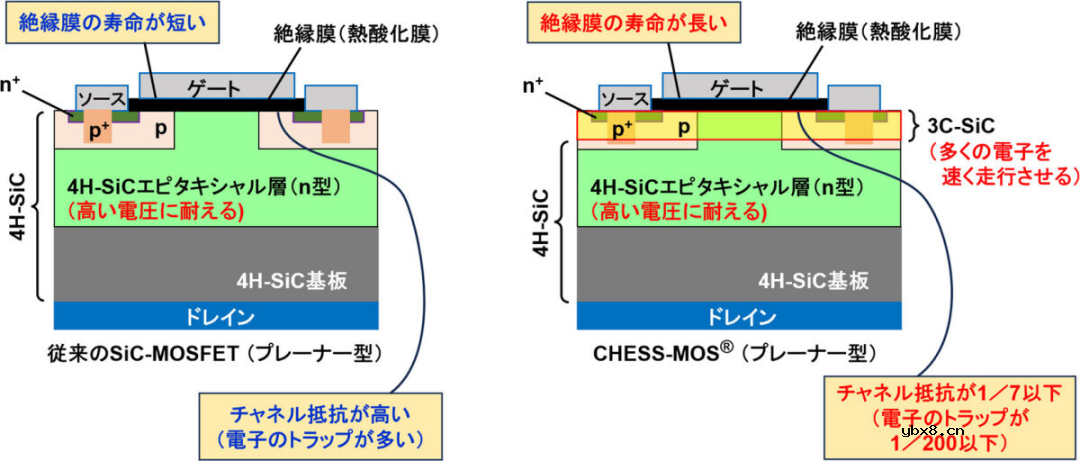
采用4H-SiC外延层的MOSFET(左),CHESS-MOS(右)
该研究团队表示,CUSIC 设计的“CHESS-MOS”能够同时降低功率损耗并确保长期可靠性。
该器件的特点是采用了混合外延层,既利用了3C-SiC的高迁移率,也利用了4H-SiC层的高耐压。
然而,要实现这一目标需要开发新的外延和晶体生长技术,以无缝堆叠两种不同晶格SiC层。因此,该研究团队开发了SLE方法。
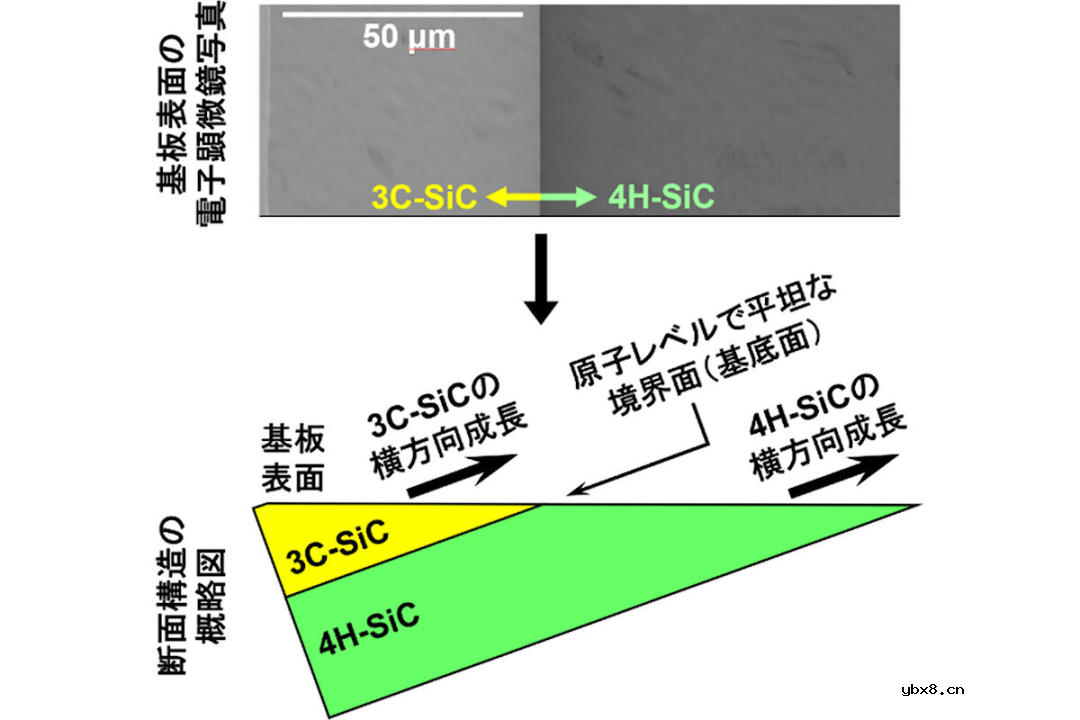
简单来说,SLE方法是在4H-SiC的延伸基面上生长3C-SiC层,3C-SiC也沿着4H-SiC基面延伸,这样使得3C-SiC层与4H-SiC层之间的界面非常平坦,没有原子偏差。
扫描非线性介电常数显微镜测量结果显示,3C-SiC表面的缺陷密度仅为4H-SiC的1/200,表明SLE方法可以大幅降低界面缺陷密度,预测CHESS-MOS可将损耗降低30%以上。
而且,由于基于3C-SiC的CHESS-MOS还可以极大地降低绝缘膜漏电流密度,消除绝缘膜在短时间内劣化的风险,提高器件的长期可靠性。
在实验中,该团队还发现,使用SLE法可以形成3C-SiC/4H-SiC/3C-SiC/4H-SiC等双量子阱结构的现象,那么通过有意地形成这种堆叠结构,可以制造高频器件,而在以前,SiC半导体器件被认为难以实现。
此外,该团队还有另一个新发现,他们通过使用SLE方法在半绝缘4H-SiC衬底上生长3C-SiC层,可避免由于与衬底电容耦合而导致的高频信号衰减问题,这将有望为高频集成电路的大规模生产铺平道路。
最为重要的是,SLE方法能够直接在SiC外延层表面的一部分引入不同的晶体结构,而无需大幅改变现有的SiC MOSFET器件形状或制造工艺,预计该技术很快可以导入器件生产线。
审核编辑:刘清
 什么是RTSP? RTSP和RTMP的区别
什么是RTSP? RTSP和RTMP的区别
时间:2026-04-24
 LCD1602显示原理
LCD1602显示原理
时间:2026-04-24
 什么是BGA?BGA的结构和性能
什么是BGA?BGA的结构和性能
时间:2026-04-24
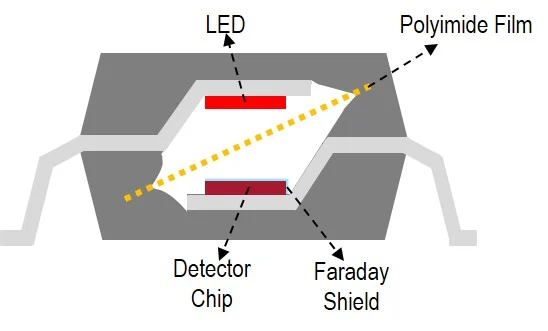 降低电机驱动风险:栅极驱动器隔离的关键作...
降低电机驱动风险:栅极驱动器隔离的关键作...
时间:2026-04-24
 电阻温度系数
电阻温度系数
时间:2026-04-24
 占空比什么意思_占空比计算公式
占空比什么意思_占空比计算公式
时间:2026-04-24
 详解卡尔曼滤波原理
详解卡尔曼滤波原理
时间:2026-04-23
 什么是IMU(惯性传感器)
什么是IMU(惯性传感器)
时间:2026-04-23
 编码器是什么?编码器有哪些分类?
编码器是什么?编码器有哪些分类?
时间:2026-04-23
 电容器颜色代码
电容器颜色代码
时间:2026-04-23
 石英灯电子变压器电路原理
石英灯电子变压器电路原理
时间:2026-03-06
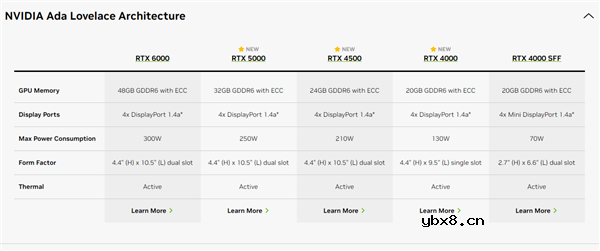 NVIDIA CPU+GPU超级芯片大升级!
NVIDIA CPU+GPU超级芯片大升级!
时间:2026-03-09
 半导体光刻工艺 光刻—半导体电路的绘制
半导体光刻工艺 光刻—半导体电路的绘制
时间:2026-03-09
 汽车芯片业应汲取的教训
汽车芯片业应汲取的教训
时间:2026-03-09
 什么是室温超导?半导体时代将走向结束?芯...
什么是室温超导?半导体时代将走向结束?芯...
时间:2026-03-09
 适用于DCM、QR的同步整流ic U7710SG介绍
适用于DCM、QR的同步整流ic U7710SG介绍
时间:2026-03-09
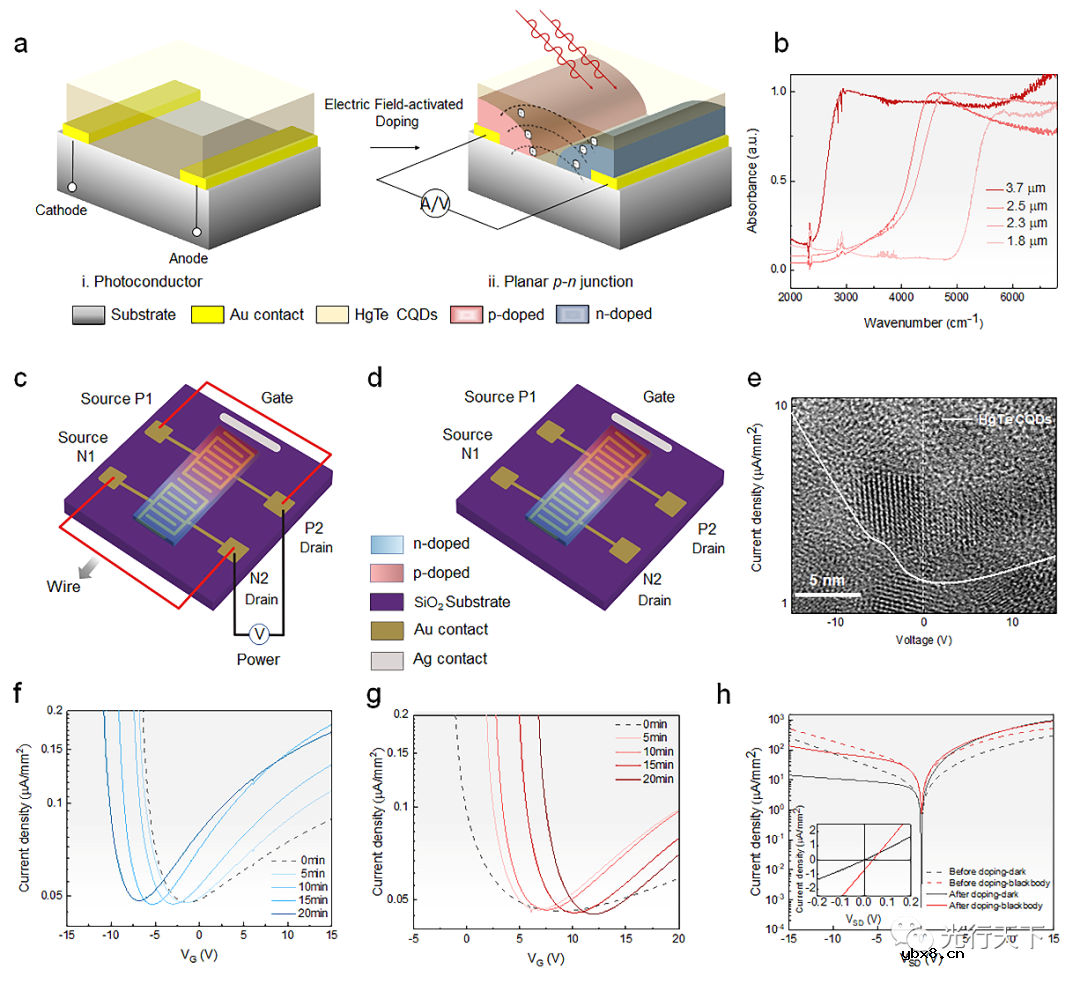 北京理工大学实现了光导型向平面光伏型量子...
北京理工大学实现了光导型向平面光伏型量子...
时间:2026-03-09
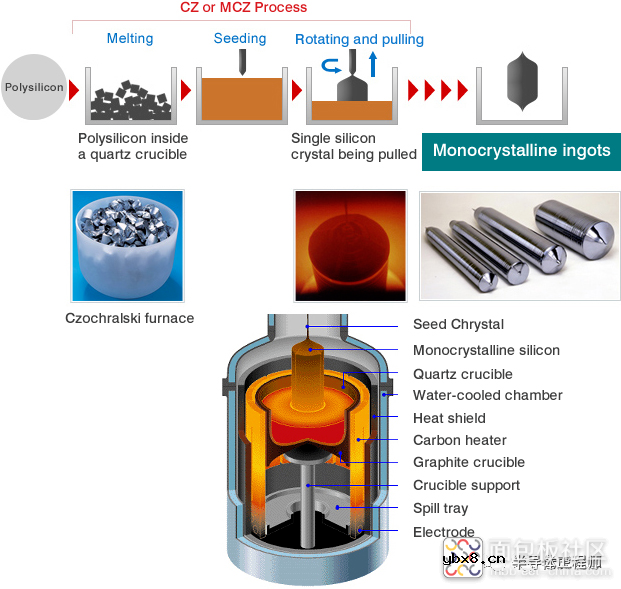 什么是硅片或者晶圆?一文了解半导体硅晶圆
什么是硅片或者晶圆?一文了解半导体硅晶圆
时间:2026-03-09
 电阻的原理和作用 电阻色环识别图 电路中电...
电阻的原理和作用 电阻色环识别图 电路中电...
时间:2026-03-09
 半导体行业之ICT技术简介
半导体行业之ICT技术简介
时间:2026-03-09