1
2000〜2010年CMOS工艺流程
有两个因素影响CMOS集成电路的速度,即栅延迟和互连延迟。栅延迟是指MOSFET开关的时间;互连延迟由芯片设计、工艺技术,以及互连的导体和电介质材料决定。
栅延迟由两个因素决定:积累足够的电荷开启MOS晶体管的时间,以及载流子(NMOS的电子和PMOS的空穴)通过栅极下面源/漏之间的沟道所需的时间。
金属-氧化物-半导体(MOS)MOSFET也形成了一个电容,其中栅极作为一个电极,半导体衬底作为另一个电极,栅氧化层位于中间作为绝缘层。
MOS电容应足够大,以至于当栅极电压超过阈值电压(片)时,在栅极下源/漏之间获得足够的载流子形成沟道,这就是MOSFET的开启。降低栅极电容可以减少形成沟道的时间并提高开关速度。
但是,如果电容过低,MOSFET将变得不稳定,因为诸如背景辐射等小的噪声就可以打开或关闭晶体管,并导致第8章所描述的软误差。
MOSFET源/漏电极之间的距离称为沟道长度,载流子需要通过沟道传导电流。减小栅极宽度可以降低载流子通过沟道的时间并提高器件的速度。
然而,这样也降低了栅极电容并可能导致器件的可靠性问题,因为MOS电容已经尽可能设计成最低的水平。为了进一步提高IC芯片的速度,具有高阻抗的衬底继续缩小特征尺寸。
绝缘体上硅(SOI)是一种候选,这种材料将硅表面的有源区和硅衬底隔开,因此几乎完全消除了辐射诱发的沟道软误差。
同时使用SOI和STI技术可以完全地隔离邻近的微电子器件,防止它们之间产生相互干扰,从而可以使芯片设计者增加IC芯片上晶体管的数量以提高封装密度。
SOI衬底上制成的集成电路芯片可以用于高辐射环境,如航天飞机、火箭和科研。另一种方法是使用体硅晶圆的应变硅沟道技术。
互连导线的电阻和它们之间的寄生电容决定了互连延迟或RC延迟。为了减少RC延迟,使用低电阻率的金属和低介电常数(低脂的电介质作为互连材料。铜的电阻率比铝铜合金低,
因此使用铜代替铝铜合金可降低功耗并提高芯片速度。传统的铝铜合金互连需要一次介质刻蚀和一次金属刻蚀,然而铜互连通常采用所谓的双镶嵌工艺过程,需要两次介质刻蚀,但不需要金属刻蚀。
这种工艺使用金属CMP代替金属刻蚀形成互连线,这是铜互连和铝铜合金互连之间的主要区别。铜互连的主要挑战是电介质刻蚀、金属沉积和金属CMP。
一些低k电介质材料的开发使用两种方法:CVD和自旋电介质(S0D)。基于CVD低电介质SiCOH的优点是技术成熟。
SOD一个重要的优点是对如多孔二氧化硅低介电常数(k<2)的材料具有延展性。
SOD在芯片封装过程中的可靠性问题最终决定了CVDSiCOH成为先进集成电路芯片大规模生产中的低k电介质材料。
审核编辑:刘清
 什么是RTSP? RTSP和RTMP的区别
什么是RTSP? RTSP和RTMP的区别
时间:2026-04-24
 LCD1602显示原理
LCD1602显示原理
时间:2026-04-24
 什么是BGA?BGA的结构和性能
什么是BGA?BGA的结构和性能
时间:2026-04-24
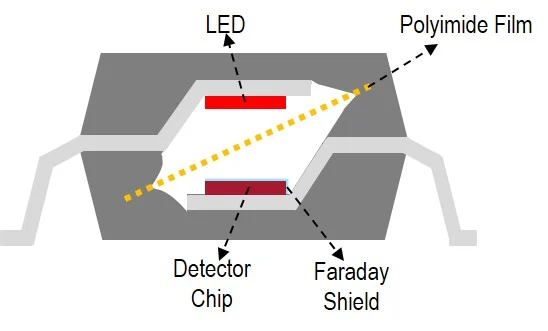 降低电机驱动风险:栅极驱动器隔离的关键作...
降低电机驱动风险:栅极驱动器隔离的关键作...
时间:2026-04-24
 电阻温度系数
电阻温度系数
时间:2026-04-24
 占空比什么意思_占空比计算公式
占空比什么意思_占空比计算公式
时间:2026-04-24
 详解卡尔曼滤波原理
详解卡尔曼滤波原理
时间:2026-04-23
 什么是IMU(惯性传感器)
什么是IMU(惯性传感器)
时间:2026-04-23
 编码器是什么?编码器有哪些分类?
编码器是什么?编码器有哪些分类?
时间:2026-04-23
 电容器颜色代码
电容器颜色代码
时间:2026-04-23
 石英灯电子变压器电路原理
石英灯电子变压器电路原理
时间:2026-03-06
 半导体光刻工艺 光刻—半导体电路的绘制
半导体光刻工艺 光刻—半导体电路的绘制
时间:2026-03-09
 什么是室温超导?半导体时代将走向结束?芯...
什么是室温超导?半导体时代将走向结束?芯...
时间:2026-03-09
 适用于DCM、QR的同步整流ic U7710SG介绍
适用于DCM、QR的同步整流ic U7710SG介绍
时间:2026-03-09
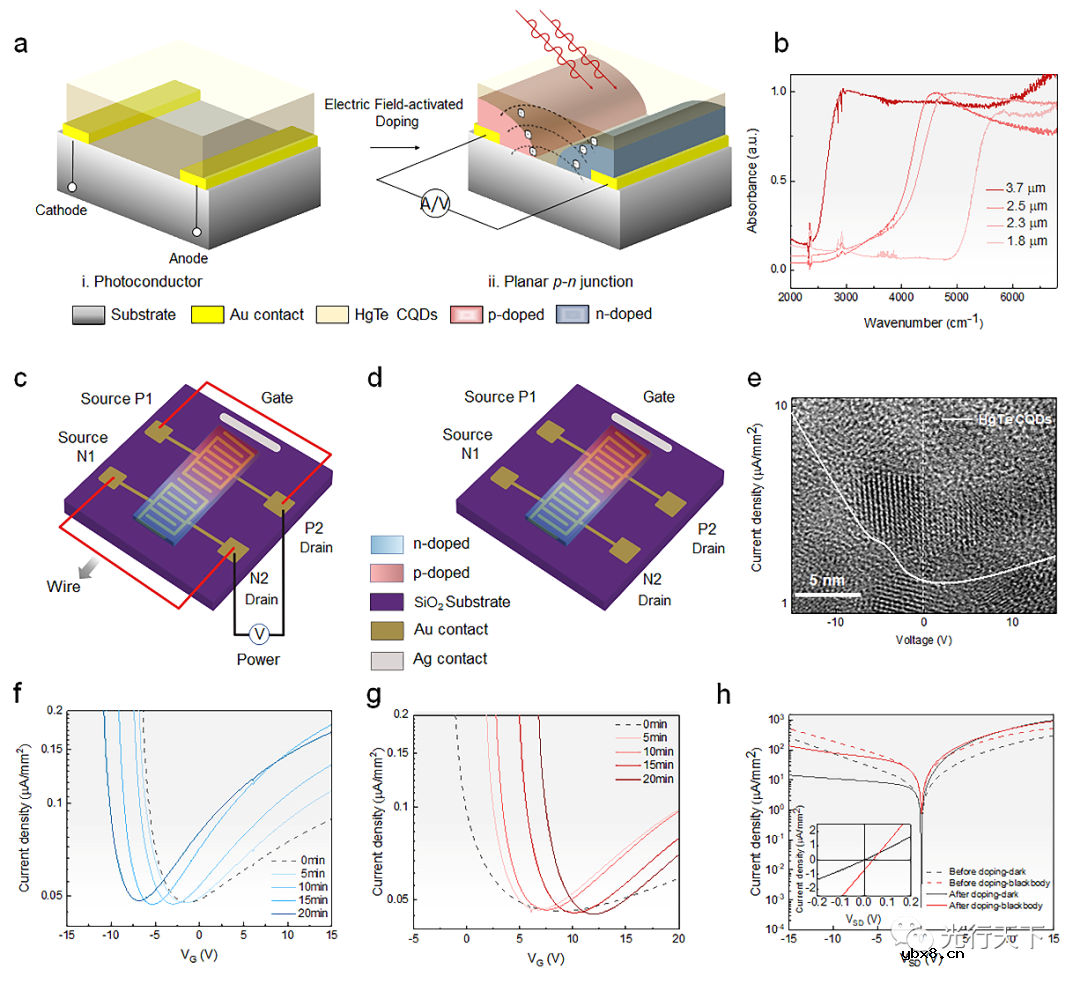 北京理工大学实现了光导型向平面光伏型量子...
北京理工大学实现了光导型向平面光伏型量子...
时间:2026-03-09
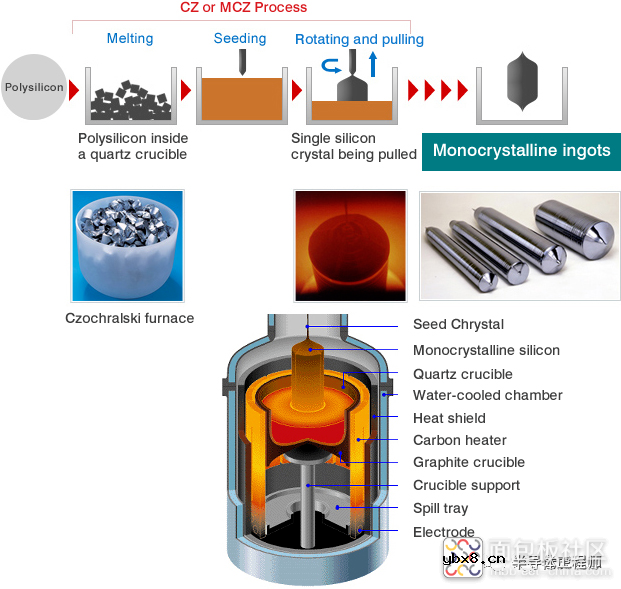 什么是硅片或者晶圆?一文了解半导体硅晶圆
什么是硅片或者晶圆?一文了解半导体硅晶圆
时间:2026-03-09
 汽车芯片业应汲取的教训
汽车芯片业应汲取的教训
时间:2026-03-09
 电阻的原理和作用 电阻色环识别图 电路中电...
电阻的原理和作用 电阻色环识别图 电路中电...
时间:2026-03-09
 半导体行业之ICT技术简介
半导体行业之ICT技术简介
时间:2026-03-09
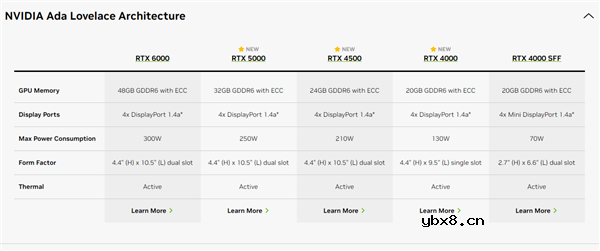 NVIDIA CPU+GPU超级芯片大升级!
NVIDIA CPU+GPU超级芯片大升级!
时间:2026-03-09