当晶体管尺寸缩小时,多晶硅内掺杂物的扩散效应可能会影响器件的性能。抑制掺杂物扩散很重要,特别是防止P型金属氧化物半导体多晶硅栅中的硼原子扩散到N型多晶硅栅中,否则可能会改变晶体管的特性,因此引进了扩散阻挡离子注入,而且高剂量的氮注入多晶硅后将捕捉硼原子并防止它们扩散形成很深的结。
低掺杂漏极(LDD)是一个低能量、低电流的离子注入过程。亚微米场效晶体管中,需要用LDD抑制热电子效应,热电子将导致元器件性能损坏且影响芯片的可靠性。所谓的热电子效应或热载流子效应,是电子从漏极到栅极以遂穿方式通过超薄栅氧化层,这是因为电子受源极/漏极偏压引起垂直电场加速。
由于离子注入浓度随着器件特征尺寸的减小而增加,对于亚0.25ptm元器件,注入的剂量已经很高,所以已经不能称其为“轻掺杂”,这种注入已经被称为源极/漏极延伸离子注入(SDE),从而为高浓度的源极/漏极掺杂提供了一个扩散缓冲层。SDE具有IC制造中最浅的结深,需要低能离子注入形成。下图说明了CMOS集成电路芯片制造中的SDE工艺形成过程。
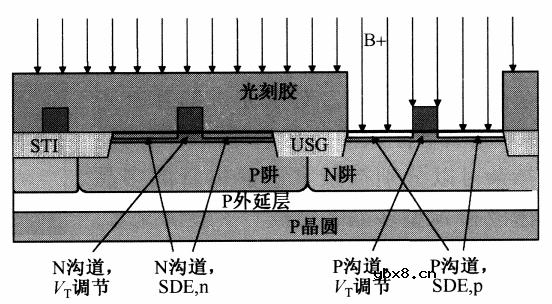
源极/漏极注入是一个高电流、低能量的离子注入过程,可能是集成电路芯片制造过程中最后一个离子注入步骤。与LDD注入最大的不同在于,SDE注入的剂量非常高,而且是在侧壁空间层形成之后才开始进行的。侧壁空间层是将重掺杂的源极/漏极与多晶硅栅正下方的沟道分开以抑制热电子效应。下图说明了源极/漏极的离子注入过程。
源极/漏极注入使用高电流离子束重掺杂硅芯片。源极/漏极注入后将在光刻胶覆盖层内形成高浓度的掺杂物原子层,从而导致干法光刻胶去除工艺困难,因为光刻胶是一种包含氢与碳的聚合物,所以氧自由基可以氧化去光刻胶。然而大部分的掺杂氧化物,例如五氧化二磷(P2O5)与三氧化二硼(B2O3)都是固体而非气体。
这些固体比较容易停留在晶圆表面造成残余物缺陷,通常称为浮渣。干法剥除之后通常需要湿法工艺去除这些残余物,这个过程称为除浮渣。很多的半导体生产中,源极/漏极注入用的遮蔽光刻胶将通过使用一种很强的氧化剂溶液剥除,例如H2O2。
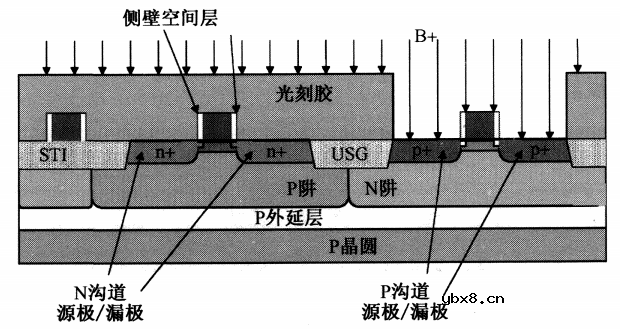
若使用LOCOS隔离技术,生长厚场氧化层之前,离子注入一般用来形成P型掺杂隔离区,这个工艺过程称为隔离离子注入或通道阻绝注入。此举可以形成围绕器件工作区的保护环,从而辅助形成相邻晶体管的电气隔离。
对于CMOS工艺,几乎每种离子注入过程都需要两次,一次是形成P型MOS场效应管,另一次是形成N型MOS场效应管。最先进的互补型CMOS晶体管集成电路芯片需要用约20道离子注入过程制造所需的微小晶体管。对于双载流子和双载流子互补型CMOS晶体管集成电路芯片,离子注入广泛用于深埋层掺杂、绝缘形成以及基极、发射极和集电极的形成。
审核编辑:刘清
 什么是PCA?何时应该使用PCA?
什么是PCA?何时应该使用PCA?
时间:2026-04-28
 仪表放大器放大倍数分析
仪表放大器放大倍数分析
时间:2026-04-28
 射频微波设计入门
射频微波设计入门
时间:2026-04-28
 变压器结构
变压器结构
时间:2026-04-28
 8种进行简单线性回归的方法分析与讨论
8种进行简单线性回归的方法分析与讨论
时间:2026-04-28
 什么是RS485通信接口
什么是RS485通信接口
时间:2026-04-28
 简单的上色装置
简单的上色装置
时间:2026-04-26
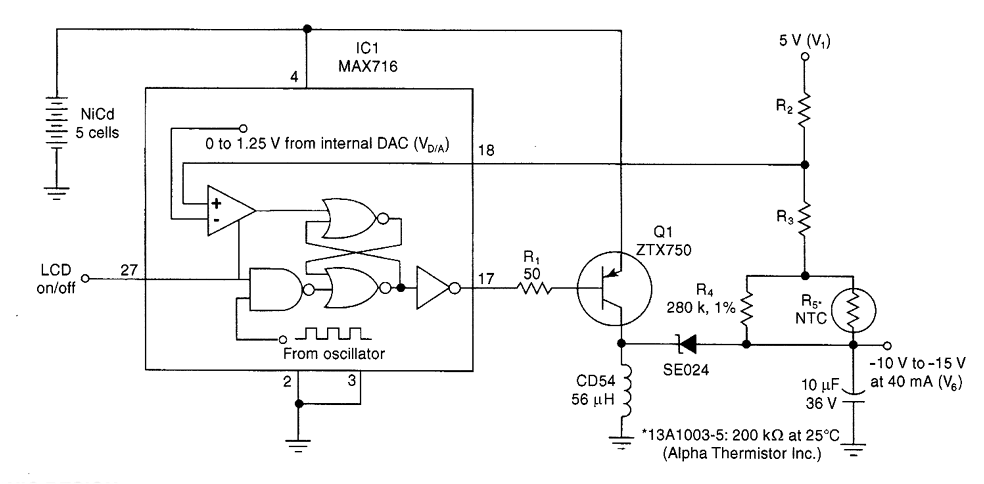 液晶屏对比度温度补偿
液晶屏对比度温度补偿
时间:2026-04-26
 双输入视频多路复用的电缆驱动器
双输入视频多路复用的电缆驱动器
时间:2026-04-26
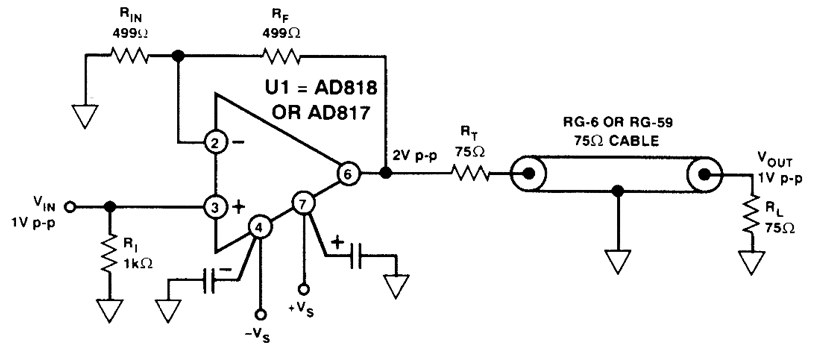 带有75Ω负载的抗阻匹配线路驱动器
带有75Ω负载的抗阻匹配线路驱动器
时间:2026-04-26
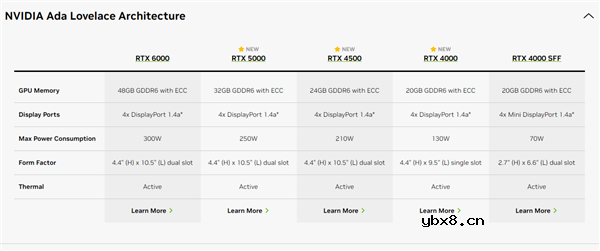 NVIDIA CPU+GPU超级芯片大升级!
NVIDIA CPU+GPU超级芯片大升级!
时间:2026-03-09
 电阻的原理和作用 电阻色环识别图 电路中电...
电阻的原理和作用 电阻色环识别图 电路中电...
时间:2026-03-09
 什么是室温超导?半导体时代将走向结束?芯...
什么是室温超导?半导体时代将走向结束?芯...
时间:2026-03-09
 石英灯电子变压器电路原理
石英灯电子变压器电路原理
时间:2026-03-06
 半导体光刻工艺 光刻—半导体电路的绘制
半导体光刻工艺 光刻—半导体电路的绘制
时间:2026-03-09
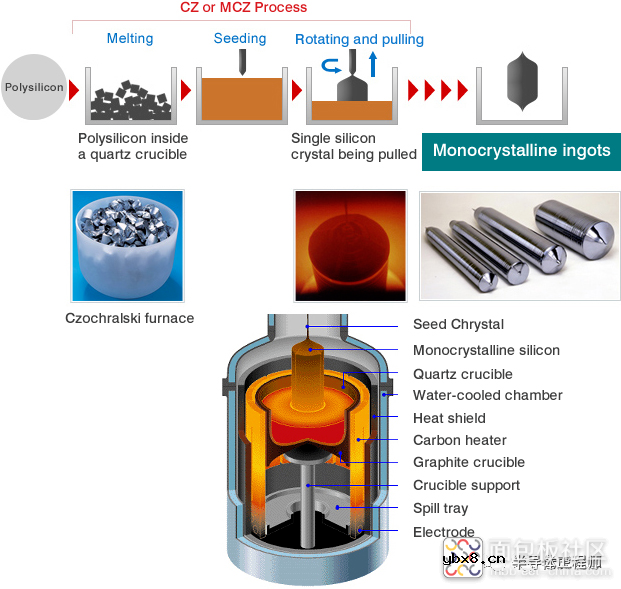 什么是硅片或者晶圆?一文了解半导体硅晶圆
什么是硅片或者晶圆?一文了解半导体硅晶圆
时间:2026-03-09
 汽车芯片业应汲取的教训
汽车芯片业应汲取的教训
时间:2026-03-09
 半导体行业之ICT技术简介
半导体行业之ICT技术简介
时间:2026-03-09
 压敏电阻有正负极吗
压敏电阻有正负极吗
时间:2026-03-05
 实用模拟电路小常识浅析
实用模拟电路小常识浅析
时间:2026-03-09