本文介绍了半大马士革工艺:利用空气隙减少寄生电容。
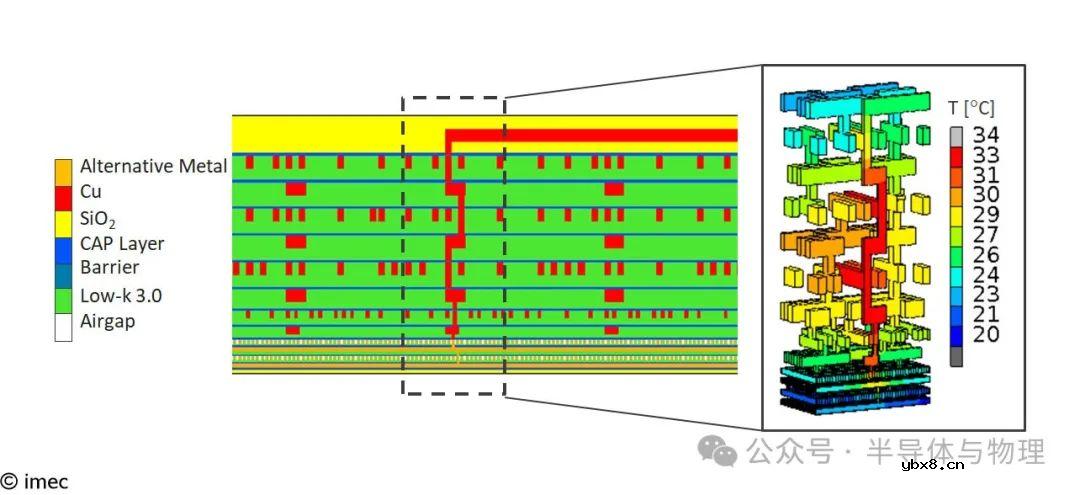
随着半导体技术的不断发展,芯片制程已经进入了3纳米节点及更先进阶段。在这个过程中,中道(MEOL)金属互联面临着诸多新的挑战,如寄生电容等问题。为了应对这些挑战,人们提出了大马士革(semi-damascene)工艺,特别是在使用钌(Ru)作为互连材料时,这种工艺显示出了显著的优势,尤其是通过引入空气隙来减少寄生电容。
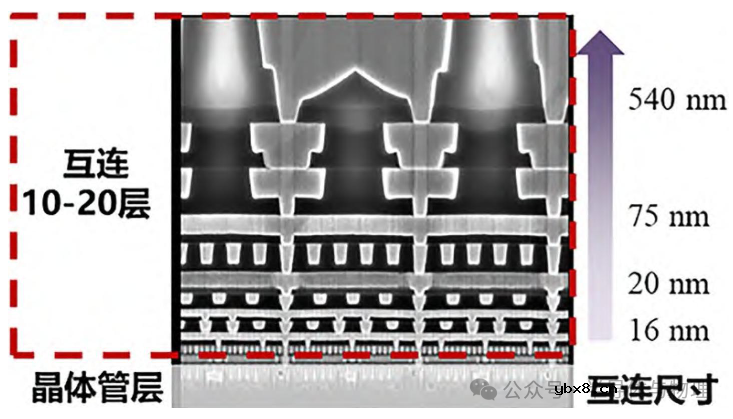
传统铜互连的问题
在传统的铜互连工艺中,随着制程节点的不断缩小,寄生电容和电阻问题变得日益严重,导致信号延迟增加,性能下降。为了解决这些问题,研究人员开始寻找替代材料和技术。
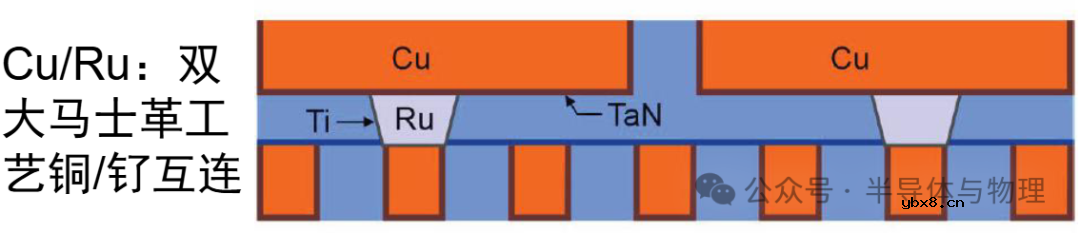
钌(Ru)作为互连材料
钌(Ru)作为一种低电阻、高可靠性的金属,成为了下一代互连材料的有力候选。钌具有以下优点: 低电阻:钌的电阻率远低于钴(Co),接近于铜(Cu),即使在极小尺寸下,其电阻增长速度也较慢。 高可靠性:钌具有出色的抗电迁移能力和高可靠性,特别适合未来的5纳米及更先进节点。 惰性和硬度:钌具有很高的惰性和硬度,不易通过化学机械抛光(CMP)去除,这使得传统的双大马士革工艺在CMP过程中容易对低k介质造成损伤,导致成品率下降。
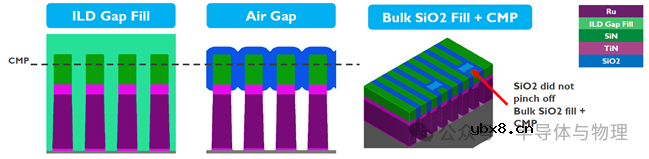
空隙的重要性
空隙(airgap)在半大马士革工艺中起到了关键作用,它可以显著降低金属线间的寄生电容,从而减少RC延时。具体来说,空气隙的引入可以: 减少电容:空气隙的介电常数接近于1,远低于传统介质材料(如二氧化硅,介电常数约为3.9),因此可以显著降低寄生电容。 提高性能:通过减少寄生电容,可以提高信号传输速度,减少信号延迟,从而提升整体性能。 降低功耗:减少寄生电容还可以降低信号传输过程中的能量损失,从而降低功耗。
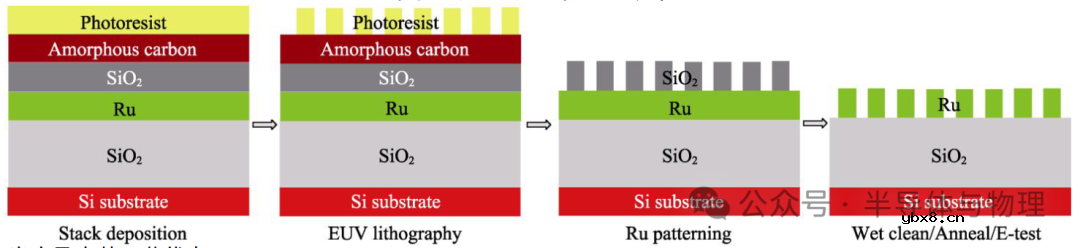
半大马士革工艺流程
M1 Ru刻蚀:使用介质作为掩模,刻蚀出M1层的钌金属线图案。 空气隙形成:使用ALD沉积一层绝缘层,在M1层的钌金属线之间形成空气隙,以减少寄生电容。 选择性通孔刻蚀:刻蚀出通孔,以便连接上下层金属线。 M2 Ru沉积:在通孔和M2层的图案上沉积钌金属。 M2 Ru刻蚀和空气隙形成:刻蚀出M2层的钌金属线图案,并在M2层的钌金属线之间形成空气隙。
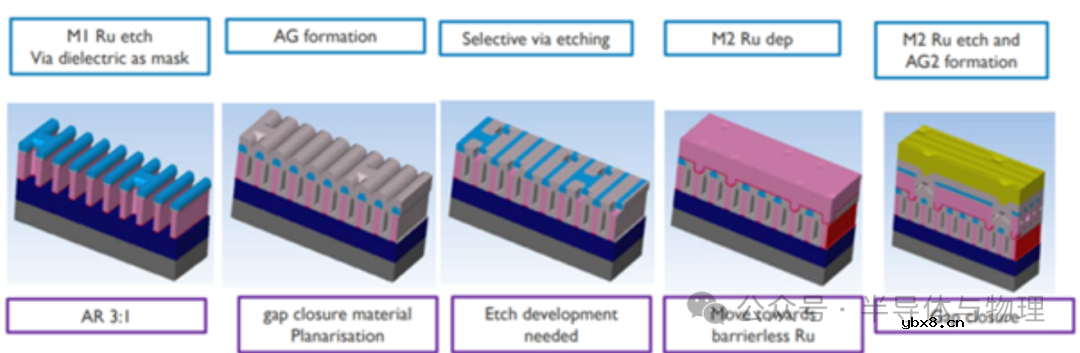
空隙的挑战与解决方案
尽管空气隙在减少寄生电容方面具有显著优势,但在实际应用中仍面临一些挑战,例如空气隙闭合的控制、平面化的要求等。研究人员通过仿真和实验,逐步解决了这些挑战,确保了工艺的稳定性和可靠性。
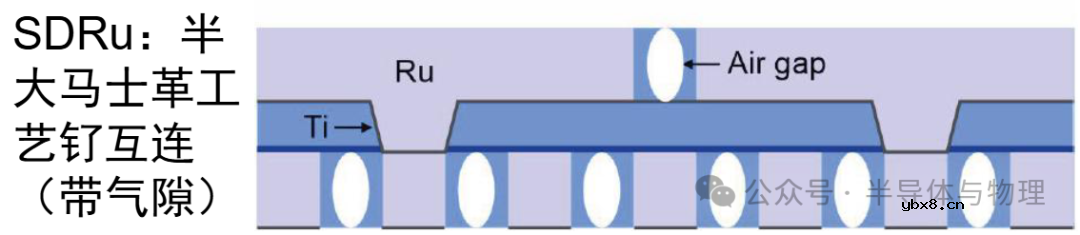
空气隙闭合控制:在M1层的钌金属线之间形成空气隙后,需要精确控制空气隙的闭合,以确保空气隙不会在后续工艺步骤中意外打开。这需要高精度的刻蚀和沉积工艺。 平面化:空气隙形成后,需要进行平面化处理,以确保介质层的表面平整,不影响后续工艺步骤。这通常通过化学机械抛光(CMP)实现。 材料选择:选择合适的空气隙闭合材料(如SiCN)和刻蚀工艺,以确保空气隙的稳定性和可靠性。
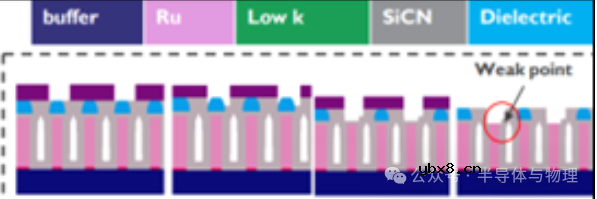
 RS485基本知识介绍
RS485基本知识介绍
时间:2026-04-18
 什么是激光雷达?激光雷达的构成与分类
什么是激光雷达?激光雷达的构成与分类
时间:2026-04-18
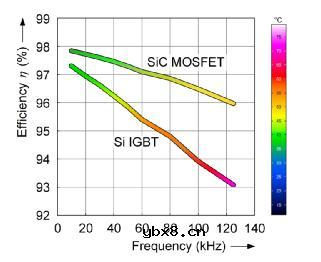 Excelpoint - 一文了解SiC MOS的应用
Excelpoint - 一文了解SiC MOS的应用
时间:2026-04-18
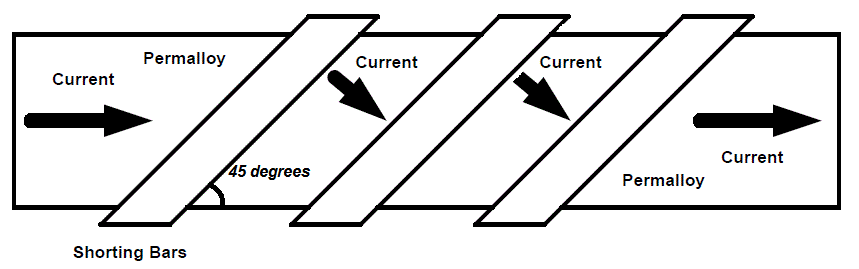 什么是磁电阻器?磁电阻特性及应用
什么是磁电阻器?磁电阻特性及应用
时间:2026-04-18
 什么是电场?电场在电容器中的应用
什么是电场?电场在电容器中的应用
时间:2026-04-18
 什么是ARM64?
什么是ARM64?
时间:2026-04-17
 vga和hdmi的区别
vga和hdmi的区别
时间:2026-04-17
 什么是ESD?ESD及TVS的原理和应用
什么是ESD?ESD及TVS的原理和应用
时间:2026-04-17
 开关电源原理与维修完整版 (10)_标清视频
开关电源原理与维修完整版 (10)_标清视频
时间:2026-04-16
 开关电源原理与维修完整版 (11)_标清视频
开关电源原理与维修完整版 (11)_标清视频
时间:2026-04-16
 半导体光刻工艺 光刻—半导体电路的绘制
半导体光刻工艺 光刻—半导体电路的绘制
时间:2026-03-09
 石英灯电子变压器电路原理
石英灯电子变压器电路原理
时间:2026-03-06
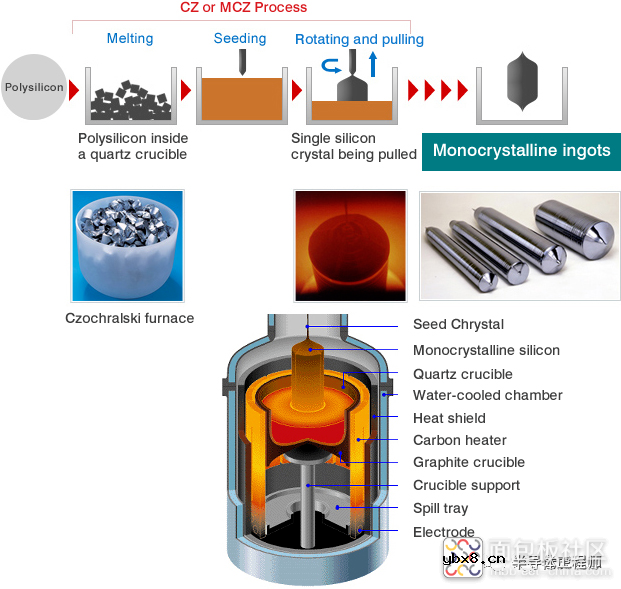 什么是硅片或者晶圆?一文了解半导体硅晶圆
什么是硅片或者晶圆?一文了解半导体硅晶圆
时间:2026-03-09
 什么是室温超导?半导体时代将走向结束?芯...
什么是室温超导?半导体时代将走向结束?芯...
时间:2026-03-09
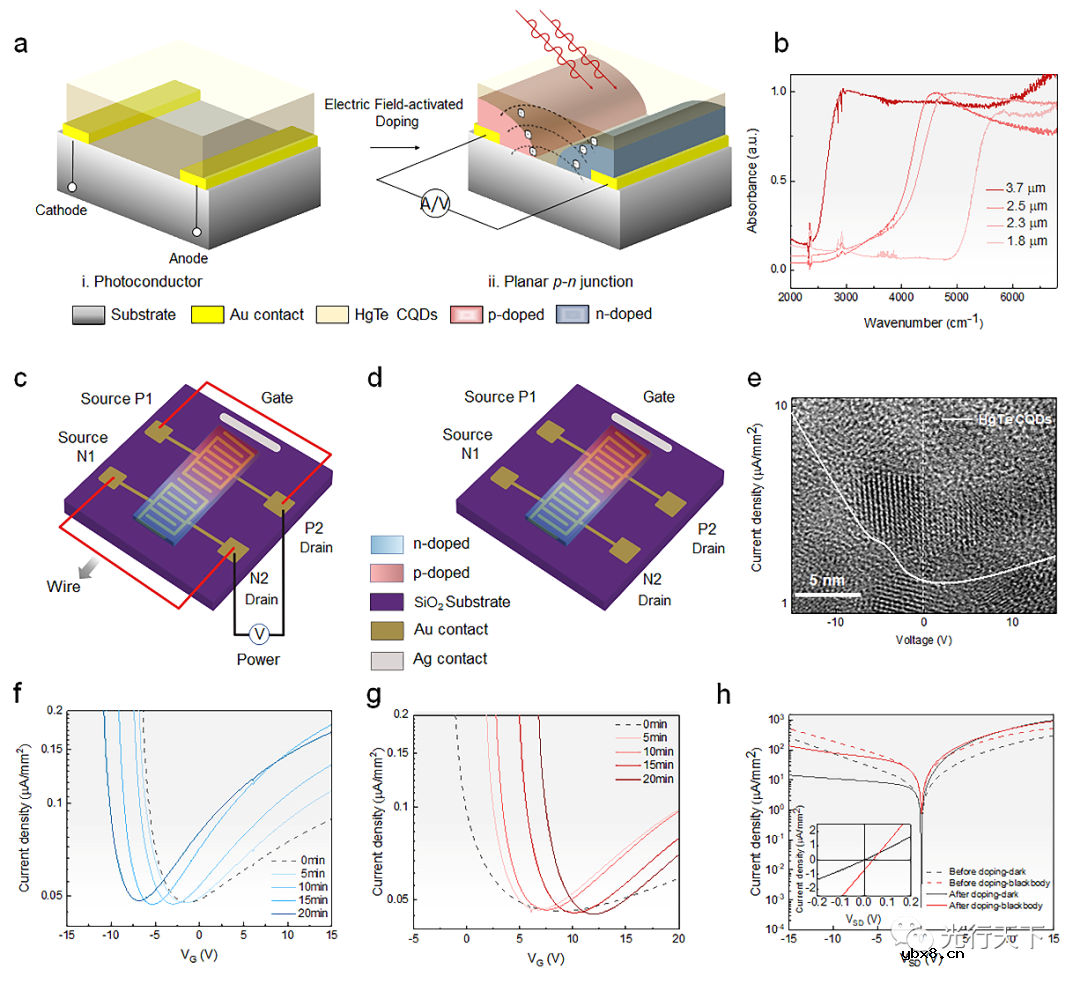 北京理工大学实现了光导型向平面光伏型量子...
北京理工大学实现了光导型向平面光伏型量子...
时间:2026-03-09
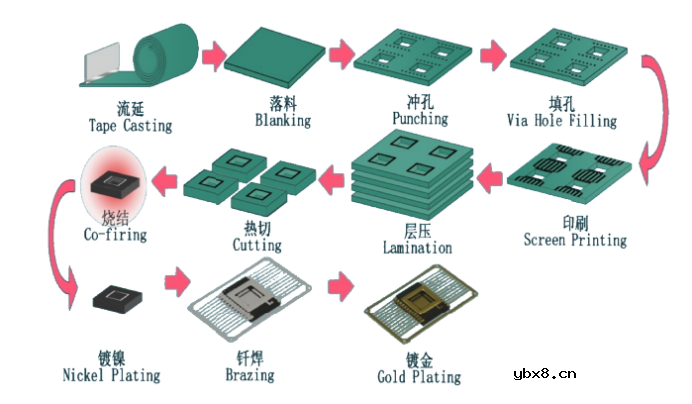 HTCC:半导体封装的理想方式
HTCC:半导体封装的理想方式
时间:2026-03-06
 如何利用可扩展的柔性中间层制备超低模量电...
如何利用可扩展的柔性中间层制备超低模量电...
时间:2026-03-09
 光伏控制器简介
光伏控制器简介
时间:2026-03-06
 电阻的原理和作用 电阻色环识别图 电路中电...
电阻的原理和作用 电阻色环识别图 电路中电...
时间:2026-03-09
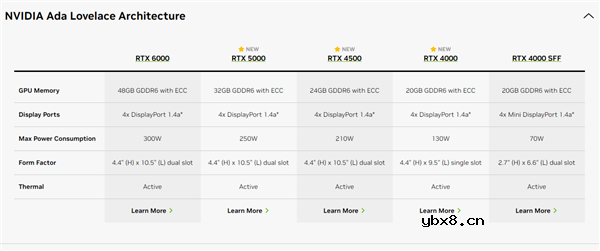 NVIDIA CPU+GPU超级芯片大升级!
NVIDIA CPU+GPU超级芯片大升级!
时间:2026-03-09