小外形封装 (Small Outine Package, SOP)器件属于引脚从封装体两侧子出呈翼状的表面贴装器件,其封装结构分 为嵌人式和外露式两种。sOP 的标准引脚节距为 1.27mm,引脚数为 6-64。 SOP 是市场上用量较大的封装形式之_SOP 是在 DIP 基础上发展而来的,衍生出的封装形式有“丁”形引脚小外形封装(SOJ)、薄小外形封装(TSOP)、带散热片的小外形封装 (HSOP)、裸露焊盘的小外形封装(ESOP)、微小外形封装(MSOP)、甚小外形封裝 (VSOP)、缩小型 SOP (SSOP)、薄的缩小型 SOP 封装 (TSSOP)、裸露焊盘薄的微小外形封装(EMSOP)、裸露焊盘薄的缩小型 SOP (ETSSOP)。这些封装的引脚节距通常在0.40~1.27mm 的范围内。
SOP 较DIP、SiP 最明显的区别在于,DIP 和 SiP 的引脚是直插式的,SOP 的引脚是呈翼状的表面贴装式的。其主要优点如下:体积小,由于 SOP 与相同引脚数的 DIP 和 SIP相比,厚度大大降低,引1脚节距至少减少 50%;与DIP 和 SIP 相比,SOP 衍生的封装类别较多;SOP 的芯片与引脚之间的连线短,寄生电容要比DIP 的小;裸露焊盘封装散热效果更好。
SOP 封装工艺是一种表面贴装型(SMD) 封装制造工艺。SOP 封装工艺流程为,首先减薄、划片,然后将IC 芯片粘贴在 SOP 引线框架的载体上,经过烘烤后,键合(打线)使芯片与芯片、芯片与内引脚相连接,再经过塑封将芯片键合丝、内引脚等包封,最后通过后固化、打标、电镇、切筋成型、测试,完成整个 SOP 生产工艺过程。
SOP 封装工艺标准流程如下图所示。

(1)减薄:己背金(背银)的圆片不减薄。非背金(背银)的圆片采用粗磨、精磨方法将原始圆片减薄。
(2)划片:根据封装需要,选择普通蓝膜、DAF (Die Attach Film)膜CDAF ( Conductive Die Attach Film)膜或 UV ( Ultra-violet Rays Fim)膜。目前划片主要采用金钢石刀片机械切割或激光切割工艺。
(3)装片:采用黏片胶、胶膜片及 UV 膜上芯了种工艺。
(4)键合:即打线,焊线有金线、铜线、银合金线和铝线等材料,采用超声波热键合工艺。
(5)塑封:SOP 采用注射式成型工艺。
(6)后固化:使用烘箱对塑封后的产品进行高温烘烤。
(7)打标:在产品正面使用激光打标机生成产品标志 (旧称“打印”)。
(8) 电镀:采用纯锡电沉积工艺。锡化后,需要对产品进行烘烤。
(9)切筋成型:在切筋成型一体机上,先冲废料、切去中筋,然后成型,自劲人管。
(10)测试:采用管装或编带一体化测试技术。
审核编辑:刘清
 RS485基本知识介绍
RS485基本知识介绍
时间:2026-04-18
 什么是激光雷达?激光雷达的构成与分类
什么是激光雷达?激光雷达的构成与分类
时间:2026-04-18
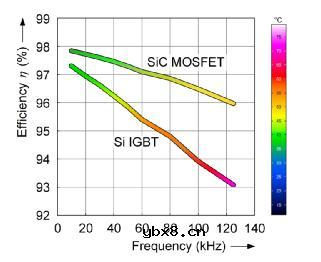 Excelpoint - 一文了解SiC MOS的应用
Excelpoint - 一文了解SiC MOS的应用
时间:2026-04-18
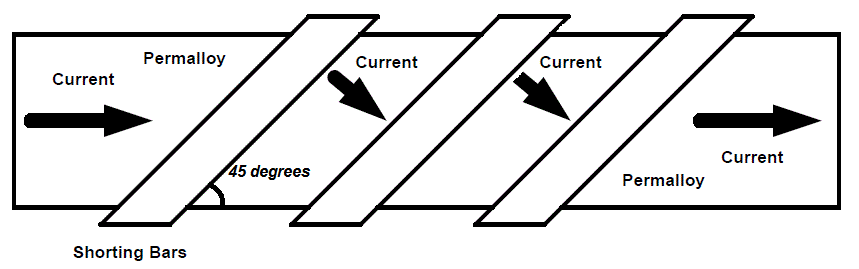 什么是磁电阻器?磁电阻特性及应用
什么是磁电阻器?磁电阻特性及应用
时间:2026-04-18
 什么是电场?电场在电容器中的应用
什么是电场?电场在电容器中的应用
时间:2026-04-18
 什么是ARM64?
什么是ARM64?
时间:2026-04-17
 vga和hdmi的区别
vga和hdmi的区别
时间:2026-04-17
 什么是ESD?ESD及TVS的原理和应用
什么是ESD?ESD及TVS的原理和应用
时间:2026-04-17
 开关电源原理与维修完整版 (10)_标清视频
开关电源原理与维修完整版 (10)_标清视频
时间:2026-04-16
 开关电源原理与维修完整版 (11)_标清视频
开关电源原理与维修完整版 (11)_标清视频
时间:2026-04-16
 半导体光刻工艺 光刻—半导体电路的绘制
半导体光刻工艺 光刻—半导体电路的绘制
时间:2026-03-09
 石英灯电子变压器电路原理
石英灯电子变压器电路原理
时间:2026-03-06
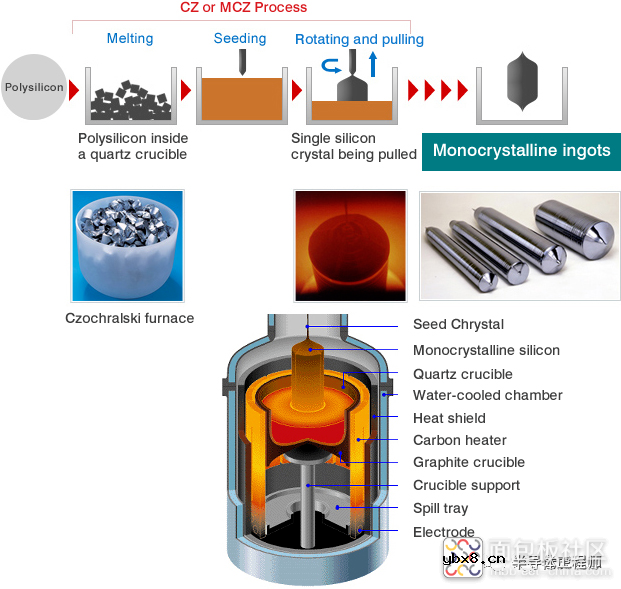 什么是硅片或者晶圆?一文了解半导体硅晶圆
什么是硅片或者晶圆?一文了解半导体硅晶圆
时间:2026-03-09
 什么是室温超导?半导体时代将走向结束?芯...
什么是室温超导?半导体时代将走向结束?芯...
时间:2026-03-09
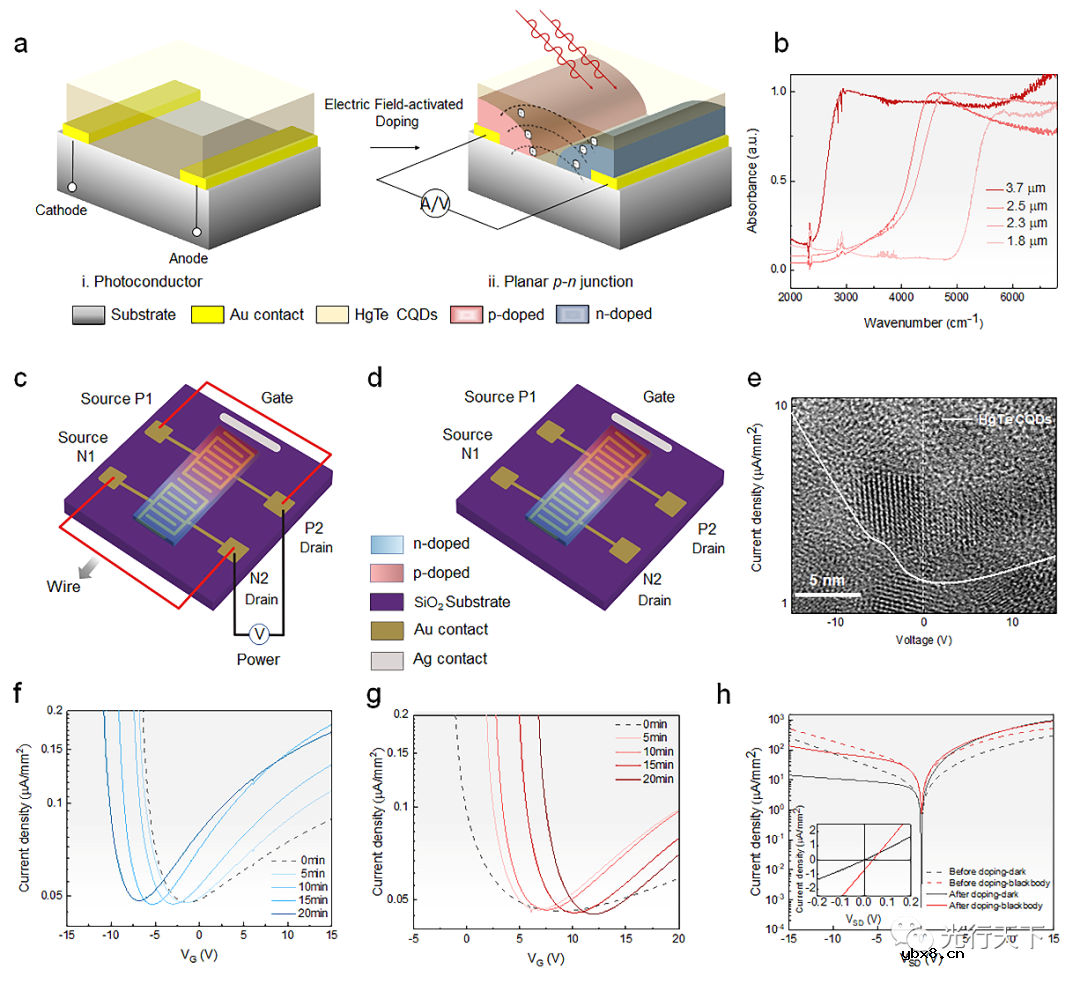 北京理工大学实现了光导型向平面光伏型量子...
北京理工大学实现了光导型向平面光伏型量子...
时间:2026-03-09
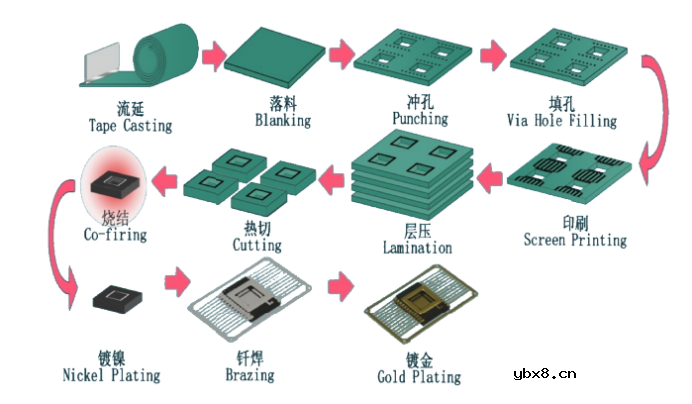 HTCC:半导体封装的理想方式
HTCC:半导体封装的理想方式
时间:2026-03-06
 如何利用可扩展的柔性中间层制备超低模量电...
如何利用可扩展的柔性中间层制备超低模量电...
时间:2026-03-09
 光伏控制器简介
光伏控制器简介
时间:2026-03-06
 电阻的原理和作用 电阻色环识别图 电路中电...
电阻的原理和作用 电阻色环识别图 电路中电...
时间:2026-03-09
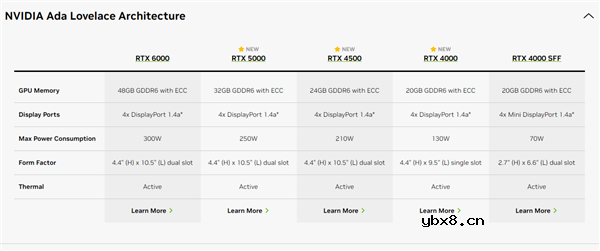 NVIDIA CPU+GPU超级芯片大升级!
NVIDIA CPU+GPU超级芯片大升级!
时间:2026-03-09