从MCM、ECP到2.5D的TSV等持续整合电子元件于更小封装的创新技术出现,主要的驱动力量就来自于永无止境地追求更轻薄短小的智慧型手机。
半导体产业持续整合电子元件于更小封装的创新能力,不断缔造出令人赞叹的成果。我很早就是一个业余的爱好者,曾经将封装于T-05金属罐的电晶体布线开发板上。这些分离式的电晶体后来已经被早期“电晶体—电晶体逻辑电路”(TTL)晶片中所用的8接脚DiP封装取代了。
一眨眼几十年过去了,封装整合技术的进展令人印象深刻。例如,图1显示从苹果(Apple) iPhone 5s智慧型手机拆解而来的村田(Murata)天线开关。其封装尺寸为3.7mm x 6.0mm,内含6个SAW滤波器、Peregrine天线开关、功率放大器,以及一系列分离式电晶体与电容器的组合。
这些元件都安装在类似FR4的电路板上,然后用模塑材料封装起来,形成完整的多晶片模组(MCM)。
图1:Murata的天线开关模组(封装模塑材料已移除)
但这并不是元件整合于封装中的唯一方式。从几年前开始,我们看到嵌入式电容器层叠封装(PoP)于应用处理器中。这种嵌入式元件封装(ECP)技术还只是先进系统级封装(SiP)解决方案使用的几种竞争策略之一。
图2是Apple协同封装A9处理器和记忆体(PoP)的照片,右侧X光影像图则显示封装基板上的嵌入式电容器。左图上方可看到APL1022的封装标识,显示这款晶片是台积电(TSMC)制造的A9处理器。当然,大家都知道三星(Samsung)也为Apple供应另一款A9晶片。
图2:Apple以PoP封装的处理器与记忆体(左)与X-ray封装图(右)
图3是Apple A9基板其中一款嵌入式电容器的扫描式电子显微镜(SEM)横截面图。该基板包含底层、中间层与顶层。我们猜测中间层经过冲压过程,从而为电容器形成腔室。
底层与顶层是以交错金属走线和电介质的方式层层堆垒起来。连接至电容器的触点可能被制造为1st与2nd铜走线形成的一部份,并以雷射钻孔方式穿过树脂封装的电容器进行过孔。填充这些过孔成为铜金属化的一部份。
在FR4基板嵌入电容器,并紧靠着A9处理器排放,这么做的目的可能是为了减少A9密集开关电晶体而产生的电杂讯。
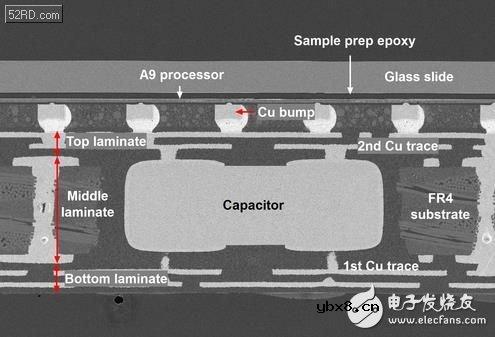
图3:Apple A9晶片封装横截面
 RS485基本知识介绍
RS485基本知识介绍
时间:2026-04-18
 什么是激光雷达?激光雷达的构成与分类
什么是激光雷达?激光雷达的构成与分类
时间:2026-04-18
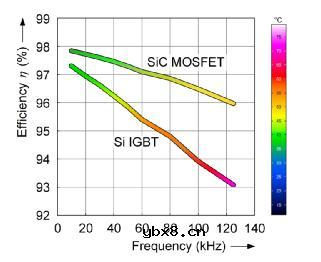 Excelpoint - 一文了解SiC MOS的应用
Excelpoint - 一文了解SiC MOS的应用
时间:2026-04-18
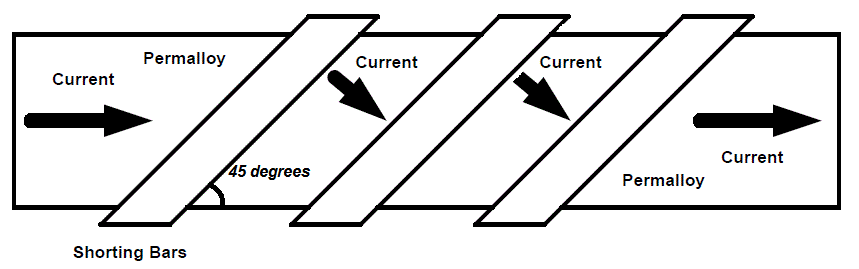 什么是磁电阻器?磁电阻特性及应用
什么是磁电阻器?磁电阻特性及应用
时间:2026-04-18
 什么是电场?电场在电容器中的应用
什么是电场?电场在电容器中的应用
时间:2026-04-18
 什么是ARM64?
什么是ARM64?
时间:2026-04-17
 vga和hdmi的区别
vga和hdmi的区别
时间:2026-04-17
 什么是ESD?ESD及TVS的原理和应用
什么是ESD?ESD及TVS的原理和应用
时间:2026-04-17
 开关电源原理与维修完整版 (10)_标清视频
开关电源原理与维修完整版 (10)_标清视频
时间:2026-04-16
 开关电源原理与维修完整版 (11)_标清视频
开关电源原理与维修完整版 (11)_标清视频
时间:2026-04-16
 什么是追踪缓存/转接卡?
什么是追踪缓存/转接卡?
时间:2026-03-06
 GPS接收机的分类
GPS接收机的分类
时间:2026-03-07
 什么是GPS旅行提示器/屏幕尺寸
什么是GPS旅行提示器/屏幕尺寸
时间:2026-03-07
 GPS的WAAS跟踪性能
GPS的WAAS跟踪性能
时间:2026-03-07
 GPS设备的动态性能
GPS设备的动态性能
时间:2026-03-07
 EMC和ESD防护技术
EMC和ESD防护技术
时间:2026-03-05
 GPS设备的地图功能
GPS设备的地图功能
时间:2026-03-07
 坐标基准
坐标基准
时间:2026-03-07
 GPS的接口有哪些类型?
GPS的接口有哪些类型?
时间:2026-03-07
 什么是EPIC
什么是EPIC
时间:2026-03-06