BGA封装的特点有哪些?
(1)I/O数较多。BGA封装器件的I/O数主要由封装体的尺寸和焊球节距决定。由于BGA封装的焊料球是以阵列形式排布在封装基片下面,因而可极大地提高器件的I/O数,缩小封装体尺寸,节省组装的占位空间。通常,在引线数相同的情况下,封装体尺寸可减小30%以上。例如:CBGA-49、BGA-320(节距1.27mm)分别与PLCC-44(节距为1.27mm)和MOFP-304(节距为0.8mm)相比,封装体尺寸分别缩小了84%和47%。
(2)提高了贴装成品率,潜在地降低了成本。传统的QFP、PLCC器件的引线脚均匀地分布在封装体的四周,其引线脚的节距为1.27mm、1.0mm、0.8mm、0.65mm、0.5mm。当I/O数越来越多时,其节距就必须越来越小。而当节距<0.4mm时,SMT设备的精度就难以满足要求。加之引线脚极易变形,从而导致贴装失效率增加。其BGA器件的焊料球是以阵列形式分布在基板的底部的,可排布较多的I/O数,其标准的焊球节距为1.5mm、1.27mm、1.0mm,细节距BGA(印BGA,也称为CSP-BGA,当焊料球的节距<1.0mm时,可将其归为CSP封装)的节距为0.8mm、0.65mm、0.5mm,与现有的SMT工艺设备兼容,其贴装失效率<10ppm。
(3)BGA的阵列焊球与基板的接触面大、短,有利于散热。
(4)BGA阵列焊球的引脚很短,缩短了信号的传输路径,减小了引线电感、电阻,因而可改善电路的性能。
(5)明显地改善了I/O端的共面性,极大地减小了组装过程中因共面性差而引起的损耗。
(6)BGA适用于MCM封装,能够实现MCM的高密度、高性能。
(7)BGA和~BGA都比细节距的脚形封装的IC牢固可靠。
 RS485基本知识介绍
RS485基本知识介绍
时间:2026-04-18
 什么是激光雷达?激光雷达的构成与分类
什么是激光雷达?激光雷达的构成与分类
时间:2026-04-18
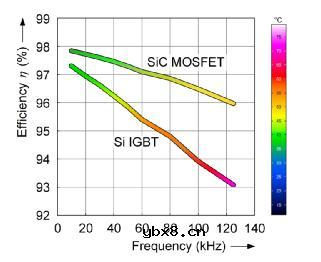 Excelpoint - 一文了解SiC MOS的应用
Excelpoint - 一文了解SiC MOS的应用
时间:2026-04-18
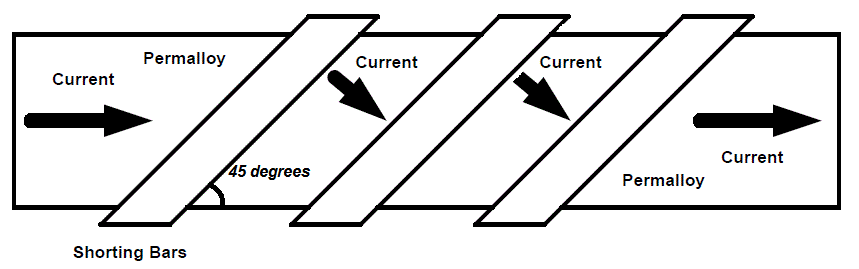 什么是磁电阻器?磁电阻特性及应用
什么是磁电阻器?磁电阻特性及应用
时间:2026-04-18
 什么是电场?电场在电容器中的应用
什么是电场?电场在电容器中的应用
时间:2026-04-18
 什么是ARM64?
什么是ARM64?
时间:2026-04-17
 vga和hdmi的区别
vga和hdmi的区别
时间:2026-04-17
 什么是ESD?ESD及TVS的原理和应用
什么是ESD?ESD及TVS的原理和应用
时间:2026-04-17
 开关电源原理与维修完整版 (10)_标清视频
开关电源原理与维修完整版 (10)_标清视频
时间:2026-04-16
 开关电源原理与维修完整版 (11)_标清视频
开关电源原理与维修完整版 (11)_标清视频
时间:2026-04-16
 什么是追踪缓存/转接卡?
什么是追踪缓存/转接卡?
时间:2026-03-06
 GPS接收机的分类
GPS接收机的分类
时间:2026-03-07
 什么是GPS旅行提示器/屏幕尺寸
什么是GPS旅行提示器/屏幕尺寸
时间:2026-03-07
 GPS的WAAS跟踪性能
GPS的WAAS跟踪性能
时间:2026-03-07
 GPS设备的动态性能
GPS设备的动态性能
时间:2026-03-07
 EMC和ESD防护技术
EMC和ESD防护技术
时间:2026-03-05
 GPS设备的地图功能
GPS设备的地图功能
时间:2026-03-07
 坐标基准
坐标基准
时间:2026-03-07
 GPS的接口有哪些类型?
GPS的接口有哪些类型?
时间:2026-03-07
 什么是EPIC
什么是EPIC
时间:2026-03-06