什么是TBGA(载带型焊球阵列) ,其优点/缺点有哪些?
什么是TBGA(载带型焊球阵列)
TBGA是一种有腔体结构,TBGA封装的芯片与基板互连方式有两种:倒装焊键合和引线键合。倒装焊键合的芯片倒装键合在多层布线柔性载带上;用作电路I/O端的周边阵列焊料球安装在柔性载带下面;它的厚密封盖板又是散热器(热沉),同时还起到加固封装体的作用,使柔性基片下面的焊料球具有较好的共面性。腔体朝下的引线键合TBGA的芯片粘结在芯腔的铜热沉上;芯片焊盘与多层布线柔性载带基片焊盘用键合引线实现互连;用密封剂将电路芯片、引线、柔性载带焊盘包封(灌封或涂敷)起来。
TBGA的优点如下:
1)封装体的柔性载带和PCB板的热匹配性能较。
2)在回流焊过程中可利用焊球的自对准作用印焊球的表面张力来达到焊球与焊盘的对准要求。
3)是最经济的BGA封装。
4)散热性能优于PBGA结构。
TBGA的缺点如下:
1)对湿气敏感。
2)不同材料的多级组合对可靠性产生不利的影响。
(5)其它的BGA封装类型
MCM-PBGA(Multiplechipmodule-PBGA)是多芯片模块PBGA。
LBGA,微BGA,它是一种芯片尺寸封装。芯片面朝下,采用TAB键合实现芯片与封装基片焊盘互连的,LBGA的结构示意图如图5。它的封装体尺寸仅略大于芯片(芯片+0.5mm)。gBGA有3种焊球节距:0.65mm、0.75mm和0.8mm。TAB引线键合和弹性的芯片粘接是txBGA的特征。与其它的芯片尺寸封装相比,它具有更高的可靠性。
图5 LBGA封装的结构示意图
SBGA(Stackedballgridarray),叠层BGA,它的结构示意图如图6所示。
图6 SBGA封装的结构示意图
etBGA,最薄的BGA结构,封装体高度为0.5mm,接近于芯片尺寸。芯片面朝下。
CTBGA、CVBGA(ThinandVeryThinChipArrayBGA),薄型、超薄型BGA。该种BGA使用的基板是薄的核心层压板,包封采用模塑结构,封装体高度为1.2mm。
相关热词:#TBGA(载带型焊球 #电子电路图
 波特率是什么意思_怎样计算波特率
波特率是什么意思_怎样计算波特率
时间:2026-04-21
 RS485基本知识介绍
RS485基本知识介绍
时间:2026-04-18
 什么是激光雷达?激光雷达的构成与分类
什么是激光雷达?激光雷达的构成与分类
时间:2026-04-18
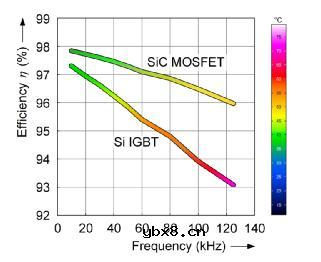 Excelpoint - 一文了解SiC MOS的应用
Excelpoint - 一文了解SiC MOS的应用
时间:2026-04-18
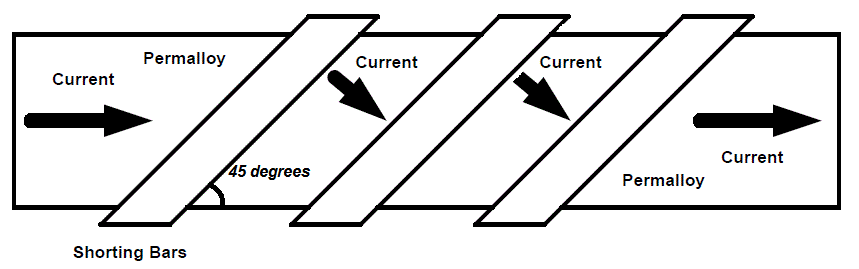 什么是磁电阻器?磁电阻特性及应用
什么是磁电阻器?磁电阻特性及应用
时间:2026-04-18
 什么是电场?电场在电容器中的应用
什么是电场?电场在电容器中的应用
时间:2026-04-18
 什么是ARM64?
什么是ARM64?
时间:2026-04-17
 vga和hdmi的区别
vga和hdmi的区别
时间:2026-04-17
 什么是ESD?ESD及TVS的原理和应用
什么是ESD?ESD及TVS的原理和应用
时间:2026-04-17
 开关电源原理与维修完整版 (10)_标清视频
开关电源原理与维修完整版 (10)_标清视频
时间:2026-04-16
 什么是追踪缓存/转接卡?
什么是追踪缓存/转接卡?
时间:2026-03-06
 GPS接收机的分类
GPS接收机的分类
时间:2026-03-07
 什么是GPS旅行提示器/屏幕尺寸
什么是GPS旅行提示器/屏幕尺寸
时间:2026-03-07
 GPS的WAAS跟踪性能
GPS的WAAS跟踪性能
时间:2026-03-07
 GPS设备的动态性能
GPS设备的动态性能
时间:2026-03-07
 EMC和ESD防护技术
EMC和ESD防护技术
时间:2026-03-05
 GPS设备的地图功能
GPS设备的地图功能
时间:2026-03-07
 坐标基准
坐标基准
时间:2026-03-07
 GPS的接口有哪些类型?
GPS的接口有哪些类型?
时间:2026-03-07
 什么是EPIC
什么是EPIC
时间:2026-03-06